
如之前的介绍用于 IC 封装的再分布层(RDL)技术及晶圆级封装中的窄间距RDL技术及应用]技术通常用于芯片封装中的信号和电源引脚映射,用于实现芯片与封装之间的连接。然而,对于高功率应用,尤其是需要传输大电流或高功率的电路,额外的考虑和技术措施是必要的。
2023-12-06 18:26

上篇文章提到用于 IC 封装的再分布层(RDL)技术Redistribution layer, RDL 的基本概念是将 I/O 焊盘的位置分配到芯片的其他位置,即用RDL转接到锡球焊接的着陆焊盘位置。
2023-12-06 18:19
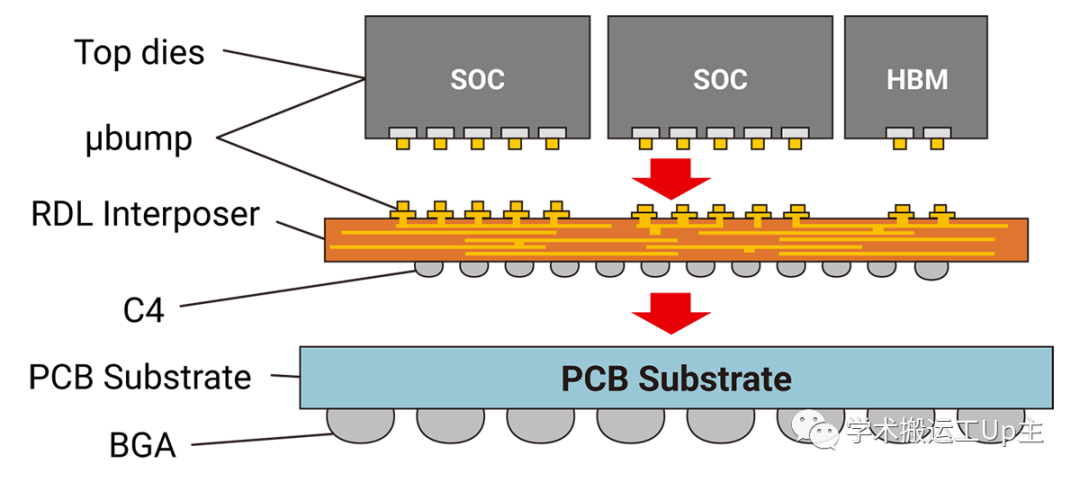
Redistribution layer (再分布层,RDL),是添加到集成电路或微芯片中以重新分配电气连接的金属层。这种RDL技术是一种用于集成电路(IC)的先进封装解决方案,允许将多个芯片集成到
2023-12-06 18:18

RDL 技术是先进封装异质集成的基础,广泛应用扇出封装、扇出基板上芯片、扇出层叠封装、硅光子学和 2.5D/3D 集成方法,实现了更小、更快和更高效的芯片设计。
2024-03-01 13:59
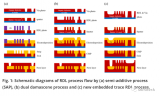
然而,SAP在定义细间距特征方面面临一些挑战。细线可能会因为高纵横比而坍塌,由于与基板的接触面积小,可能会出现分层,并且用作模板的光刻胶可能会残留在通孔中[3]。
2023-07-05 10:34
临时键合需要键合(bonding)和剥离(debonding)两种工艺。从扇出型晶圆级封装(fan-out wafer-level packaging,FoWLP)到功率器件,每种应用在工艺温度、机械应力和热预算等方面都有独特的要求,因此确定合适的剥离技术比较困难。这里只是枚举了几个例子,实际情况更为复杂。我们将在本文中重点讨论激光剥离(laser debonding):如抗高温更兼容的材料可应用于哪些情况,激光剥离的特性适于哪些应用等。
2018-07-10 09:27
目前,大多RDL是用“光刻定义”电介质构造的,其中所需的电路图案先通过光刻印刷,然后再用湿法刻蚀去除曝光或未曝光区域来获得的。
2018-08-30 09:42
用的signal wire,用于信号传输线。Special wire就是我们所说的电源线,也就是电源接地线,还有用于flipchip绕线的RDL routing(封装层绕线)。
2020-05-19 16:23

扇出型封装一般是指,晶圆级/面板级封装情境下,封装面积与die不一样,且不需要基板的封装,也就是我们常说的FOWLP/FOPLP。扇出型封装的核心要素就是芯片上的RDL重布线层(可参考下面图表说明
2023-11-27 16:02

等提供小尺寸、高性能的芯片。通过综述 TSV、TGV、 RDL 技术及相应的 2.5D、3D 异质集成方案,阐述了当前研究现状,并探讨存在的技术难点及未来发 展趋势。
2023-04-26 10:06