arity Substrate是一个区块链开发框架,具有许多很酷的功能,如可升级的区块链,模块化架构,可定制的块执行逻辑和热插拔共识。
2019-07-29 11:51
substrate和并发runtime模块是用rust开发的,rust是一种静态类型语言,具有内存安全特性,提供速度和可靠性。 这是一个在区块链开发中经常被忽视的主题,但对于采用是至关重要
2019-09-18 10:15
Substrate 作为第一个区块链领域的技术框架,让开发者能够专注于链的运行时逻辑,而不用再花费大量的时间精力构建区块链底层的基础设施。
2019-12-06 11:46
衬底(substrate)是由半导体单晶材料制造而成的晶圆片,衬底可以直接进入晶圆制造环节生产半导体器件,也可以进行外延工艺加工生产外延片。
2024-05-23 11:49
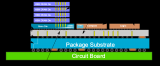
CoWoS,是Chip on Wafer on Substrate的简称。这一长串名词可以分为CoW与WoS。CoW,将芯片(有源硅芯片)堆叠在中介层(无源硅片)上,WoS则是将中介层再堆叠在基板上,三层堆叠最终形成立体封装形式。
2023-08-28 14:59
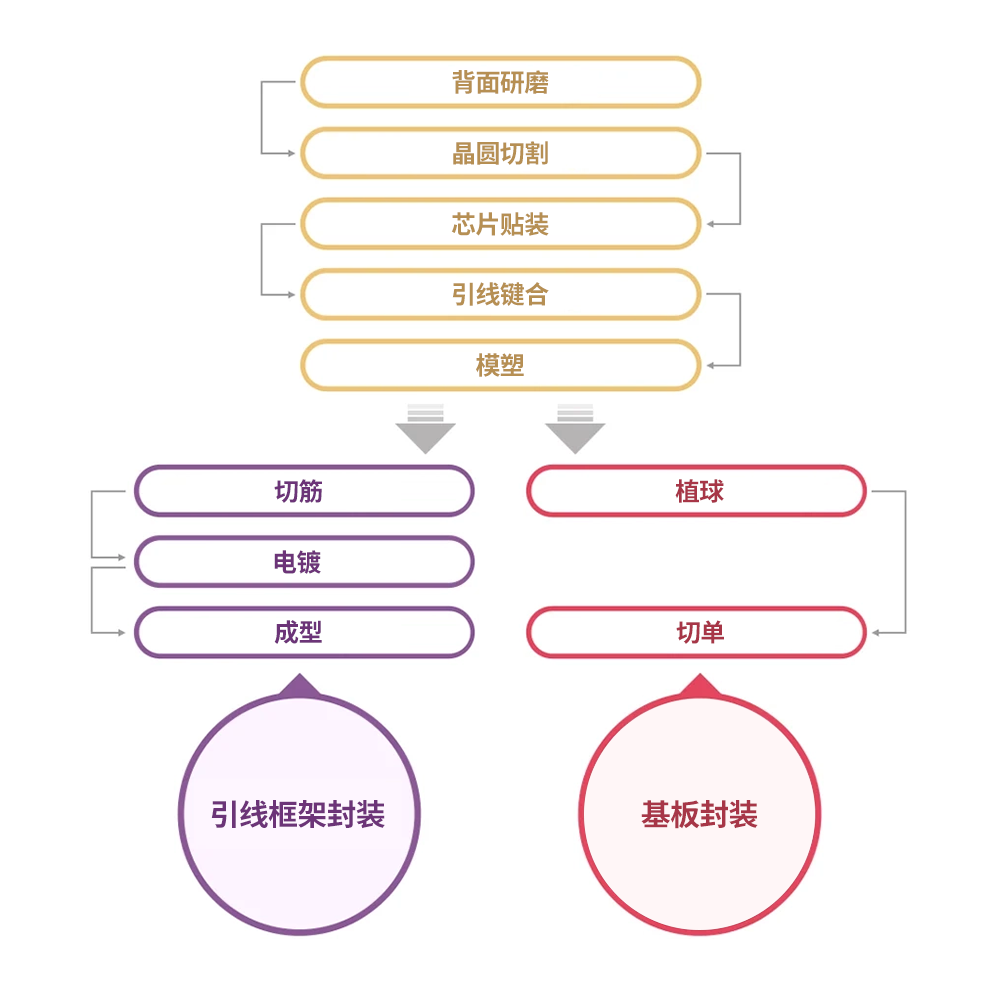
图1显示了塑料封装的组装工艺,塑料封装是一种传统封装方法,分为引线框架封装(Leadframe Package)和基板封装(Substrate Package)。这两种封装工艺的前半部分流程相同,而后半部分流程则在引脚连接方式上存在差异。
2023-10-17 14:28

芯片键合,作为切割工艺的后道工序,是将芯片固定到基板(substrate)上的一道工艺。引线键合(wire bonding)则作为芯片键合的下道工序,是确保电信号传输的一个过程。wire bonding是最常见一种键合方式。
2023-11-07 10:04
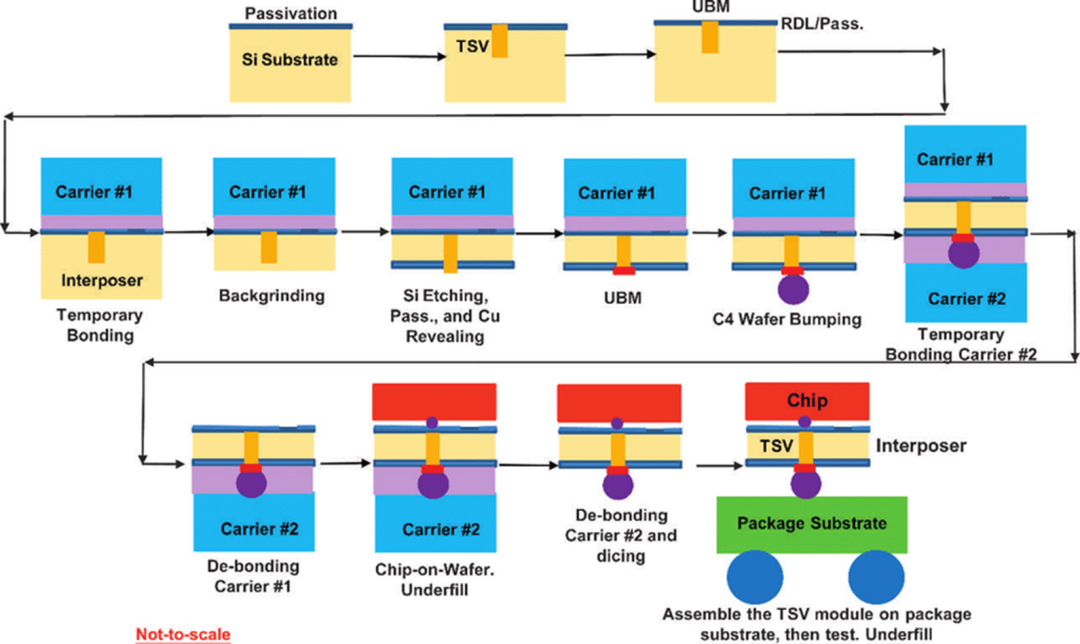
CoWoS(Chip-on-Wafer-on-Substrate),指的是将多个裸片(die)集成在一个TSV转换板(interposer)上,然后将这个interposer连接到一个基板上。CoWoS是一种先进的3D-IC封装技术,用于高性能和高密度集成的系统级封装。
2024-10-18 14:41

DBA直接覆铝陶瓷基板(Direct Bonding Aluminum Ceramic Substrate,简称DBA)是一种新型的电子材料,将会成为未来电子材料领域的新宠。代表性的制造厂商,日本三菱、日本电化,目前国内头家量产企业为江苏富乐华。
2023-05-22 16:16

碳化硅单晶衬底材料(Silicon Carbide Single Crystal Substrate Materials,以下简称SiC衬底)也是晶体材料的一种,属于宽禁带半导体材料,具有耐高压、耐高温、高频、低损耗等优势,是制备大功率电力电子器件以及微波射频器件的基础性材料。
2023-05-18 09:54