
FCBGA基板技术不同于普通基板。首先,随着数据处理芯片的尺寸增加到70 mmx 70 mm,配套的FCBGA基板从80 mmx80 mm向110 mmx110mm的更大尺寸过渡。
2023-06-19 12:48
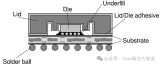
本文简单介绍了倒装芯片球栅阵列封装与倒装芯片级封装的概念与区别。 FCCSP与FCBGA都是倒装,怎么区分?有什么区别?
2024-11-16 11:48

信息时代,我们目睹着数据量不断膨胀,推动着芯片性能的飞速提升,例如处理器的浮点计算能力、网络芯片的带宽、存储器的容量。核心芯片必须不断提升互连速度和密度,IO速率每4~6年翻一番的发展速度已不能满足对芯片性能提升的诉求,因此,提升密度成为不可或缺的途径。
2023-12-12 11:03

在材料方面,对于大尺寸系统级芯片(SoC)封装来说,FCBGA基板的CTE需要更低,才能保证大尺寸芯片封装的可靠性。ABF材料进一步降低CTE的难度很大,BT材料的半固化片的CTE可以达到1
2023-07-19 11:48
华进半导体在FCBGA基板封装技术领域通过多年的投入和技术积累,目前已经形成了大基板设计、仿真,关键工艺开发和小批量制造等一体化标准流程,填补了大尺寸FCBGA国内工艺领域空白。 FCBGA
2021-03-29 17:48
作为兴森科技在广州FCBGA封装基板的实施主体,广州兴森成立于2022年3月,按计划将在广州投资约60亿元投建生产及研发基地,项目分两期建设,一期预计2025年达产,产能为1000万颗/月,满产产值为28亿元;
2023-08-03 16:01
对于FCBGA(Flip Chip Ball Grid Array)倒装球栅阵列封装的CPU芯片来说,通常有2个传热路径:一部分热量通过封装底面的焊盘传导至主板上进行散热;另外一部分热量通过封装顶面
2023-04-14 12:31
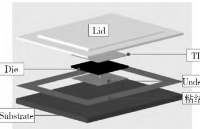
数值模拟(有限体积法)的方法,对某国产FCBGA封装的CPU散热性能进行研究,分析CPU封装内的各层材料尺寸、导热系数及功率密度等因素对CPU温度和热阻的影响。研究结果表明:TIM1导热系数在35 W/(m
2023-04-14 09:23

倒装芯片球栅格阵列(FCBGA)基板作为人工智能、5G、大数据、高性能计算、智能汽车和数据中心等新兴需求应用的CPU、图形处理器(GPU)、FPGA等高端数字芯片的重要载体
2023-05-04 09:12
随着2022年底ChatGPT的问世,我们不仅见证了从互联网时代到AI应用时代的跨越,也迎来了一个数据流量不断攀升的新纪元。在这个以数据为核心的新时代,算力网络成为支撑巨大数字经济的基石,其背后则是对硬件性能持续提升的迫切需求。
2023-11-29 11:01