电子发烧友
2500次浏览
硅通孔技术(Through Silicon Via, TSV)技术是一项高密度封装技术,正在逐渐取代目前工艺比较成熟的引线键合技术,被认为是第四代封装技术。TSV技术通
2018-08-14 15:39

onsemi TSV 封装的 SiPM 传感器的处理和焊接
2022-11-14 21:08

在上篇文章中介绍了扇入型晶圆级芯片封装(Fan-In WLCSP)、扇出型晶圆级芯片封装(Fan-Out WLCSP)、重新分配层(RDL)封装、倒片(Flip Chip)封装
2023-11-08 10:05
为了按比例缩小半导体IC,需要在300mm的晶圆上生成更精细的线条。据市场研究机构VLSI Research(图1)预测,虽然目前大多数量产的IC是基于55nm或55nm以下的设计节点,但这些设计规则将缩小至38nm或更小,到2013年甚至会缩小到27nm。
2018-08-21 14:43

硅通孔(TSV) 是当前技术先进性最高的封装互连技术之一。基于 TSV 封装的核心工艺包括 TSV 制造、RDL/微凸点
2023-05-08 10:35
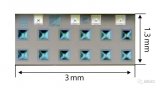
TSV封装技术被认为是第四代封装技术,并正在逐渐取代目前工艺比较成熟的引线键合技术,8英寸晶圆级封装实现了更好的电气互联性能、更低的功耗、更小的尺寸、更轻的质量,以及更
2023-06-12 10:25
硅通孔(TSV)电镀的高可靠性是高密度集成电路封装应用中的一个有吸引力的热点。本文介绍了通过优化溅射和电镀条件对完全填充TSV的改进。特别注意具有不同种子层结构的样品。这些样品是通过不同的溅射和处理
2021-01-09 10:19

Hello,大家好,我们来分享下先进封装中TSV需要的相关设备。
2025-02-19 16:39

)、重新分配层(RDL)封装、倒片(Flip Chip)封装、及硅通孔(TSV)封装。此外,本文还将介绍应用于这些晶圆级封装
2023-11-08 09:20

硅通孔技术(Through Silicon Via, TSV)技术是一项高密度封装技术,正在逐渐取代目前工艺比较成熟的引线键合技术,被认为是第四代封装技术。TSV技术通
2016-10-12 18:30