使用专用机器ITC THP 30填充特殊孔堵塞树脂TAIYO THP-100 DX1热固化永久孔填充材料。树脂通孔填充所需的额外生产步骤是在 2层PCB生产过程之前执行
2018-05-14 09:48
填充宽度是指在焊接过程中,焊盘与焊芯之间的间隔。填充宽度的大小直接影响到焊接质量、焊接强度和焊接过程的稳定性等方面。填充宽度过大可能会导致诸多问题,本文将从焊接质量、焊接强度和焊接过程的稳定性三个
2023-12-26 17:15
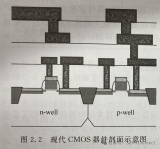
图2.2是现代CMOS 器件剖面的示意图。一般来说,水平方向的尺寸微缩幅度比垂直方向的幅度更大,这将导致沟槽(包含接触孔)的深宽比(aspect ratio)也随之提高,为避免沟槽填充过程中产生空穴
2025-05-21 17:50

电工基础:如何计算电缆桥架填充率
2020-07-03 17:37

),这些可能导致额外的耗时工作,例如由于一个小的变更就需要全部重新对布局进行填充。对于45纳米及以下的情况,新的制造要求不仅大大提高了金属填充位置的复杂性,还显著增加了设计中填充组件的数量。
2018-06-07 09:34

出于让PCB焊接时尽可能不变形的目的,大部分PCB生产厂家会要求PCB设计者在PCB的空旷区域填充铜皮或者网格状的地线。
2018-05-05 09:41
覆铜,就是将PCB上闲置的空间作为基准面,然后用固体铜填充,这些铜区又称为灌铜。
2018-08-04 10:16