目前在LED制程中,蓝宝石基板虽然受到来自Si与GaN基板的挑战,但是考虑到成本与良率,蓝宝石在近两年内仍然具有优势.由于蓝宝石硬度仅次于钻石,因此对它进行减薄与表面平坦化加
2012-10-18 09:58

在封装前,通常要减薄晶圆,减薄晶圆主要有四种主要方法:机械磨削、化学机械研磨、湿法蚀刻和等离子体干法化学蚀刻。
2024-01-26 09:59
,满足晶圆的翘曲度的要求。但封装的时候则是薄一点更好,所以要处理到100~200um左右的厚度,就要用到减薄工艺。 满足封装要求 降低封装厚度 在电子设备不断向小型化、轻薄化发展的趋势下,对集成电路
2024-12-24 17:58
`我司有进口的减薄砂轮(可替代DISCO减薄砂轮),钻石液,UV膜,等半导体耗材以及研磨抛光减
2014-06-19 13:42

本文主要讲述TSV工艺中的硅晶圆减薄与铜平坦化。 硅晶圆减薄与铜平坦化作为 TSV 三维集成技术的核心环节,主要应用于含铜 TSV 互连的
2025-08-12 10:35
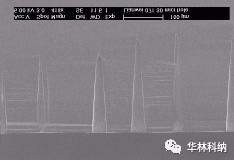
本文提出了一种用于实现贯穿芯片互连的包含沟槽和空腔的微机械晶片的减薄方法。通过研磨和抛光成功地使晶圆变薄,直至达到之前通过深度反应离子蚀刻蚀刻的空腔。研究了腐蚀结构损坏的可能原因。研究了空腔中颗粒
2022-03-29 14:56
激光器都是在外延的基础上做出芯片的结构设计,外延厚度2寸的在350um,4寸的在460um左右,到芯片后期,都需要对晶圆进行减薄,厚度有做到80um的,也有120um的
2022-07-15 12:01
“减薄”,也叫 Back Grinding(BG),是将晶圆(Wafer)背面研磨至目标厚度的工艺步骤。这个过程通常发生在芯片完成前端电路制造、被切割前(即晶圆仍然整体时),是连接
2025-05-30 10:38
集成电路芯片不断向高密度、高性能和轻薄短小方向发展,为满足IC封装要求,越来越多的薄芯片将会出现在封装中。此外薄芯片可以
2010-05-04 08:09