
扇出型封装一般是指,晶圆级/面板级封装情境下,封装面积与die不一样,且不需要基板的封装,也就是我们常说的FOWLP/FOPLP。扇出型封装的核心要素就是芯片上的RDL重布线层(可参考下面图表说明
2023-11-27 16:02

Fanout,即扇出,指模块直接调用的下级模块的个数,如果这个数值过大的话,在FPGA直接表现为net delay较大,不利于时序收敛。因此,在写代码时应尽量避免高扇出的情况。但是,在某些特殊情况下,受到整体结构设计的需要或者无法修改代码的限制,则需要通过其它优化
2019-10-13 14:55

Xilinx推荐对于低扇出的触发器控制信号在代码编写时尽量吸收进触发器D输入端之前的LUT中,并在XST的综合属性选项中提供配置项,让XST综合时自动将低扇出的控制信号吸收进触发器D输入端之前的LUT
2023-12-14 15:04
扇出型晶圆级封装最大的优势,就是令具有成千上万I/O点的半导体器件,通过二到五微米间隔线实现无缝连接,使互连密度最大化,实现高带宽数据传输,去除基板成本。
2022-03-23 14:02

高密度扇出型封装技术满足了移动手机封装的外形尺寸与性能要求,因此获得了技术界的广泛关注。
2020-07-13 15:03

RDL 技术是先进封装异质集成的基础,广泛应用扇出封装、扇出基板上芯片、扇出层叠封装、硅光子学和 2.5D/3D 集成方法,实现了更小、更快和更高效的芯片设计。
2024-03-01 13:59

翘曲(Warpage)是结构固有的缺陷之一。晶圆级扇出封装(FOWLP)工艺过程中,由于硅芯片需通过环氧树脂(EMC)进行模塑重构成为新的晶圆,使其新的晶圆变成非均质材料,不同材料间的热膨胀和收缩程度不平衡则非常容易使重构晶圆发生翘曲。
2025-05-14 11:02

AD9508提供时钟扇出能力,针对能使系统性能达到优质的低抖动进行设计。这款器件能满足时钟数据转换器等应用所需的相位噪声和低抖动要求,可优化这些应用的性能。
2025-04-10 14:05
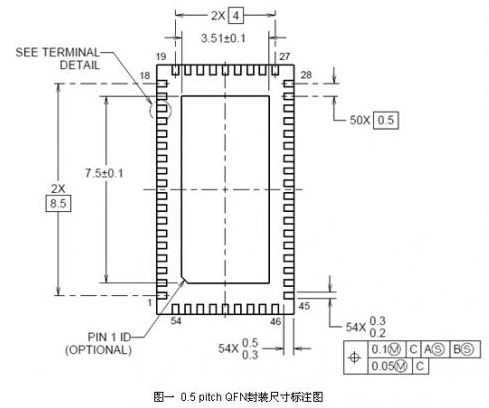
在PCB设计中,QFN封装的器件通常使用微带线从TOP或者BOTTOM层扇出。对于小间距的QFN封装,需要在扇出区域注意微带线之间的距离以及并行走线的长度。
2019-10-04 17:09
高扇出指的是一个逻辑单元驱动的逻辑单元过多。常见于寄存器驱动过多的组合逻辑单元。至于驱动多少逻辑单元算过多,需要根据工艺,后端实现情况以及芯片本身类型来决定。
2023-03-26 13:45