本文通过对高速BGA封装与PCB差分互连结构的优化设计,利用CST全波电磁场仿真软件进行3D建模,分别研究了差分布线方式、信号布局方式、信号孔/地孔比、布线层与过孔残桩这四个方面对高速差分信号
2019-05-29 15:14
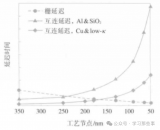
本文介绍了影响集成电路可靠性的Cu/low-k互连结构中的电迁移问题。
2025-03-13 14:50

本文介绍了采用芯和半导体ViaExpert软件进行TSV阵列的建模和仿真分析流程。TSV结构复杂,存在
2022-06-03 09:03

先进封装中硅通孔(TSV)铜互连电镀研究进展
2023-09-06 11:16

为了适应高速信号传输,芯片多采用差分信号传输方式。随着芯片I/O 引脚数量越来越多,BGA焊点间距越来越小,由焊点、过孔以及印制线构成的差分互连结构所产生的寄生效应将导致衰减、串扰等一系列信号完整性问题,这对高速
2023-09-28 17:28
芯片和封装基板的互连,以及芯片和芯片的互连。TSV技术通过铜、钨、多晶硅等填充,实现垂直电气互连。硅通孔技术可以通过垂直互连
2022-05-31 15:24
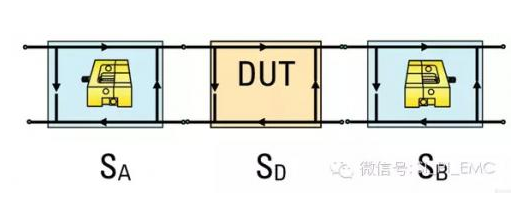
自动夹具移除(AFR)校准技术是一种提取准确的宽带夹具模型的简便方法。这种校准技术可以被用于各种夹具和互连的结构,例如转接头、芯片封装、线缆、PCB印刷传输线以及通孔这样的互连
2019-08-30 14:22

等提供小尺寸、高性能的芯片。通过综述 TSV、TGV、 RDL 技术及相应的 2.5D、3D 异质集成方案,阐述了当前研究现状,并探讨存在的技术难点及未来发 展趋势。
2023-04-26 10:06

硅通孔技术(Through Silicon Via, TSV)技术是一项高密度封装技术,正在逐渐取代目前工艺比较成熟的引线键合技术,被认为是第四代封装技术。TSV技术通过铜、钨、多晶硅等导电物质
2016-10-12 18:30

随着通信技术的发展,射频电路在通信系统中得到了广泛的应用。功率放大器的研究和设计一直是通信发展中的重要课题。近年来,基于模糊神经网络的射频器件和电路建模的研究取得了巨大的成果,对大规模集成电路和复杂电路的
2017-11-23 16:43