电子发烧友
1w次浏览
尽管目前AiP的实现工艺主要有LTCC(低温共烧结陶瓷)、HDI(高密度互联)及FOWLP(晶圆级扇出式封装)三种,但是我们认为,基于更高的集成度、更好的散热性、更低的传输损耗等优势,结合目前的产业化进度,FOWLP有望成为AiP天线的主流技术工艺。
2022-08-29 10:10
据最新消息,三星的Exynos 2400芯片将采用扇出式晶圆级封装(FOWLP)技术。这种封装技术使得Exynos 2400在性能和散热能力方面有了显著提升。
2024-01-22 16:07
日月光2014年起跟随台积电脚步投入FOWLP封装技术研发,原本采用面板级(Panel Level)扇出型技术,但今年已转向晶圆级(Wafer Level)技术发展,并在下半年完成研发并导入试产
2016-10-24 15:52
在智能手机性能日益强大的今天,应用处理器(AP)的散热问题成为了制约其性能释放的关键因素。为了应对这一挑战,三星电子正全力以赴,开发一项名为FOWLP-HPB的革新性芯片封装技术,旨在从根本上解决AP过热问题,为未来的Exynos芯片提供强有力的散热保障。
2024-07-05 11:10
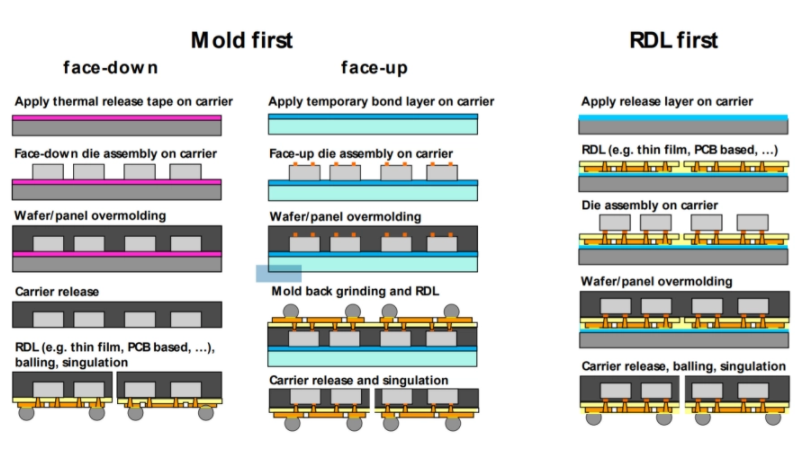
摩尔定律在制程技术中处于最后一刻,因此高级包装占据了接力棒。扇出晶圆级封装(FOWLP)等先进技术可提高组件密度并提高性能,并帮助解决芯片I / O限制。然而,成功使用这种技术的关键是从一开始就将
2021-04-01 16:44
近几年中,芯片特征尺寸已接近物理极限,而先进封装技术成为延续摩尔定律的重要途径。一系列新型封装技术出现在人们视野之中。而其中扇出型晶圆级封装(FOWLP)被寄予厚望,它将为下一代紧凑型、高性能的电子设备提供坚实而有力的支持。
2022-07-10 15:06
据海外媒体报道,扇出型晶圆级封装(FOWLP)能以更小型的外观造型规格(form factor)、更轻薄的封装、更高的I/O密度以及多晶粒解决方案,创造许多性能与成本上的优势,因此成为近年来半导体
2016-12-13 11:02
理器(Application Processor,AP)上采用“扇出型晶圆级封装(Fan-out Wafer Level Package,FOWLP)”技术,带动该封装技术市场急速扩大,且预期 2017 年会有更多厂商将采用
2017-01-19 07:07
IT之家了解到,借助FOWLP技术,有助于增强芯片组的I/O功能并加快电信号传输速度,同时提升其抗热性,使SoC能够维持更稳定高效的多核性能。据悉,三星在Exynos2400产品描述中指出,此技术能使多核性能提升约8%。
2024-03-06 16:05
韩媒报导,苹果(Apple)决定将iPhone 7行动应用处理器(AP)A10交由台积电代工,关键在于台积电拥有后段制程竞争力。台积电具备扇出型晶圆级封装(Fan-out WLP;FoWLP)技术,将其称为整合型扇型封装(Intgrated Fan Out;InFO)。
2018-04-23 11:51