BGA的返修步骤 BGA的返修步骤与传统SMD的返修步骤基本相同,具体步骤如下: 1.拆卸BGA (1)将需要拆卸BGA的表面组装板安放在返修系统
2010-08-19 17:36
普通热风SMD返修系统的原理是:采用非常细的热气流聚集到表面组装器件(SMD)的引脚和焊盘上,使焊点熔化或使锡膏回流,以完成拆卸或焊接功能。 拆卸同时使用一个装有弹簧和橡皮吸嘴的真空机械装置,当全部
2017-09-26 09:30
随着电子产品向小型化,便携化,网络化和高性能方向发展,对电路组装技术和I/O引线数提出了更高的要求.芯片体积越来越小,芯片引脚越来越多,给生产和返修带来困难.
2010-11-13 23:13
摘要在当今电子产品的组装中各种新的封装技术不断涌现BGA/CSP是当今新的封装主流主要论述了BGA封装技术的主要类型特性并根据实际经验介绍了实际生产中如何实施BGA的返修工艺
2010-11-13 23:20

电子发烧友网站提供《带TFT显示屏的STM32焊接和返修台.zip》资料免费下载
2023-02-02 14:50
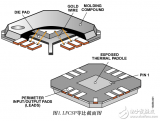
,LFCSP常常还有较大的裸露热焊盘,可将其焊接到 PCB以改善散热。 LFCSP器件返修 将LFCSP器件装配到PCB上之后,若发现缺陷,应当返修 以移除不良器件,并换上工作正常的器件。移除器件之 前,注意必须加热不良器件,直至引脚和裸露焊盘(如有焊 接)下
2017-09-12 19:54
针对温度控制系统的大惯性、大时延等特性,根据模糊控制理论,设计出一种模糊自整定PID 控制器,并应用于BGA 返修站温度控制系统,实现了PID 参数的在线自整定。仿真实验表
2009-08-15 10:35
随着电子技术的飞速发展,封装的小型化和组装的高密度化以及各种新型器件的不断涌现,对装联质量的要求也越来越高。BGA(BallGridArray,意为球状矩阵排列),一种典型芯片封装
2010-11-13 23:58
2015-09-21 17:37

AN-1389: 引线框芯片级封装(LFCSP)的建议返修程序
2021-03-21 07:08