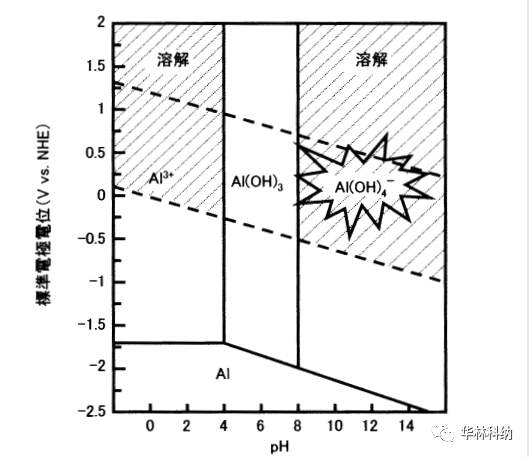
RCA清洗技术是用于清洗硅晶圆等的技术,由于其高可靠性,30多年来一直被用于半导体和平板显示器(FPD)领域的清洗。其基础是以除去颗粒为目的的氨水-过氧化氢溶液组成的SC―1洗涤和以除去金属杂质为
2022-04-21 12:26
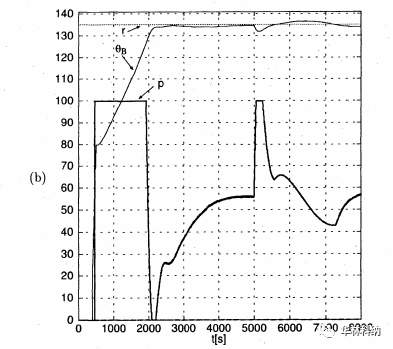
化学反应,由于清洗系统具有处理腐蚀性清洗溶液的特殊设备,系统具有长而波动的时间滞后等。在这里,我们首先提出了一个系统的热模型,其中通过DSC(差分扫描量热法)方法,我们分析了清洗溶液的放热化学反应,如SPM(硫酸/过氧化氢混合物)、APM(氨/过氧化氢混合物)和H
2022-04-15 14:55

的构成元素和它们在其中具体的个数。化学家使用更精确的术语“化合物”来描述元素的不同组合。因此,H2O(水),NaCl(氯化钠或盐),过氧化氢(过氧化氢)和As2O3都是不同的化合物,它们都是由单个分子的集合体组成的。
2023-12-03 14:07

在选择真空压力计或者表压传感器时,精度当然是最重要的考虑因素之一。这两种情况下,精度越高则过程控制越好。这在过氧化氢等离子体灭菌过程中尤其重要,该灭菌过程各个阶段的压力都必须被精确控制才可有效工作。确认真空压力计或者表压传感器的精度实际上是度量它们的误差。更加复杂的是,每种仪器计算精度的方法都不同。
2018-06-25 13:30
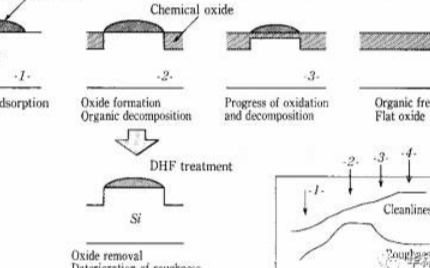
近年来,作为取代SPM(硫酸/过氧化氢)清洗的有机物去除法,通过添加臭氧的超纯水进行的清洗受到关注,其有效性逐渐被发现。在该清洗法中,可以实现清洗工序的低温化、操作性的提高、废液处理的不必要化
2022-04-13 15:25
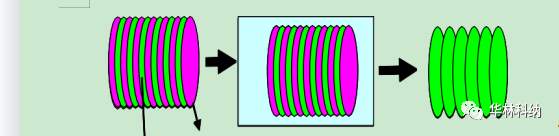
对于亚微米或深亚微米 ULSI 的制造,完全抑制在硅晶片表面产生的颗粒和污染非常重要。清洁需求的传统概念是使用化学成分(APM、氨和过氧化氢混合物)发挥主要作用。不幸的是,SC-1 (APM) 对表
2022-03-30 14:29