一说到2D或者3D,总是让人想到视觉领域中的效果,然而在半导体领域,3D技术带来的革命更叹为观止,早些年的FinFET和3D NAND只是个开始。
2019-01-25 14:29
一说到二维(2D)或三维(3D),总是让人想到人眼视觉效果,然而在半导体领域,3D技术带来的革命更叹为观止,早些年的FinFET和3D NAND只是个开始。从2018年
2019-01-29 11:09

应用,新的TSV技术将于2019年上市,即来自英特尔(Intel)的Foveros(基于“有源”TSV中介层和3D SoC技术,具有混合键合和TSV互连(可能)技术)。Foveros的出现表明,虽然“TSV”受到了来自“无TSV”技术的挑战,但厂商仍然对它很有信心
2019-02-15 10:42
这个过程包含了多个算法和步骤。根据无人机采集的数据,采用英特尔® 至强处理器能够快速分析处理上万张图片,并计算出破损的长度和宽度,规划修缮所需材料,并提供裂缝和塌方等破损的测量数据用于指导物理修缮。有了这些数据,修缮团队就无需再现场测量,而是可以通过AI算法得到最终需要的时间、人力、物力和成本。
2018-07-24 10:21
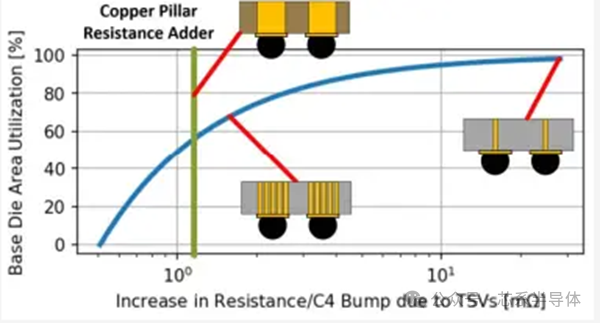
随着工艺节点的进步,英特尔也在不断推进下一代封装技术的发展。对高性能硅需求与工艺节点开发相结合,创造了一种新的方案,即处理器不再是单片硅,而是依赖于多个较小(且可能优化过)的芯粒或芯片,通过一种有利于性能、功耗和最终产品的方式
2024-10-09 15:32

2.5D 和 3D 半导体封装技术对于电子设备性能至关重要。这两种解决方案都不同程度地增强了性能、减小了尺寸并提高了能效。2.5D
2024-01-07 09:42

相对于传统平面型的金丝键合焊接的MMIC应用,三维(3D)多芯片互连封装MMIC以其高集成度、低损耗、高可靠性等性能优势,正逐步在先进电路与系统中得到应用。而3D封装引
2023-08-30 10:02

随着当今越来越多的ECAD和MCAD一体化设计的需求,对PCB的封装实现3D效果就越来越重要。
2019-08-14 10:48

近年来,由于传统外形PC的需求变得越来越萧条,英特尔努力尝试研发了多种计算机外形和尺寸,试图重燃客户热情。
2019-08-12 17:16
计算机视觉爆炸式发展的背后是3D成像领域的巨大发展。今天的3D成像是什么状态,我们的发展方向是什么?
2020-10-09 14:25