在半导体制造领域,电气过应力(EOS)和静电放电(ESD)是导致芯片失效的两大主要因素,约占现场失效器件总数的50%。它们不仅直接造成器件损坏,还会引发长期性能衰退和可靠性问题,对生产效率与产品质量构成严重威胁。
2025-08-21 09:23

芯片失效分析中对芯片的截面进行观察,需要对样品进行截面研磨达到要观察的位置,而后再采用光学显微镜(OM Optical Microscopy)或者扫描电子显微(SEM Scanning Electron Micros
2025-05-15 13:59

LED灯珠是一个由多个模块组成的系统。每个组成部分的失效都会引起LED灯珠失效。
2020-03-22 23:13
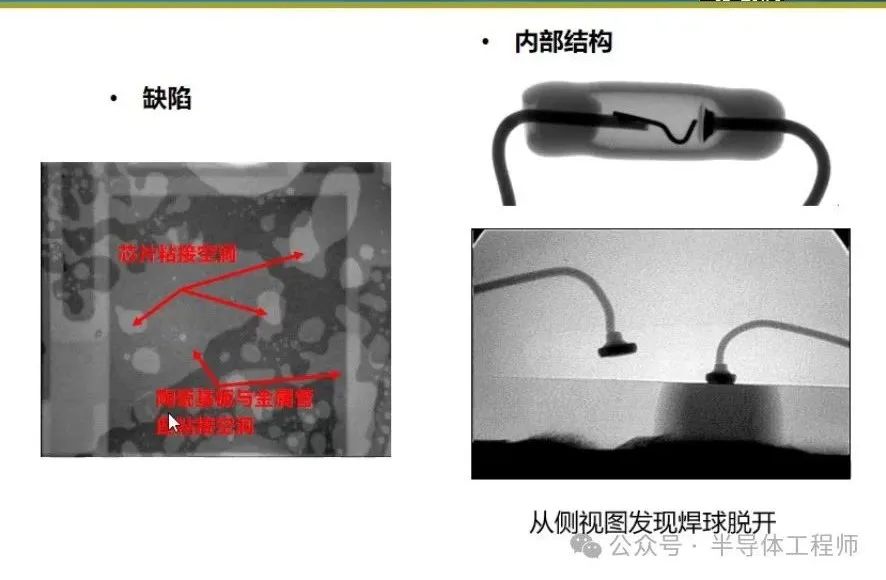
在芯片失效分析中,常用的测试设备种类繁多,每种设备都有其特定的功能和用途,本文列举了一些常见的测试设备及其特点。
2024-08-07 17:33
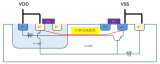
闩锁效应(Latch-up)是CMOS工艺中一种寄生效应,通常发生在CMOS电路中,当输入电流过大时,内部电流急剧增加,可能导致电路失效甚至烧毁芯片,造成芯片不可逆的损伤。
2024-12-27 10:11
审核编辑:彭静
2022-10-24 10:33
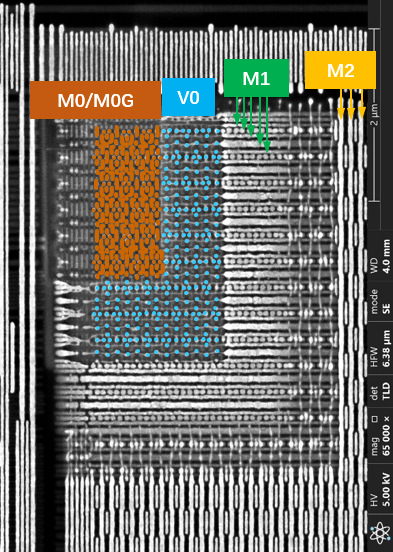
由于存储器中包括结构重复的存储单元,当其中发生失效点时, 如何定位失效点成为存储器失效分析中的最为重要的一步。存储器芯片的集成度高,字线(WL)和位线(BL)之间发生微
2024-08-19 15:48