去离子水不能完全替代氨水,二者在成分、功能及应用场景上存在本质差异。以下是具体分析: 化学性质与作用机制不同 氨水(NH₄OH)是一种弱碱性溶液,含有铵根离子和氢氧根离子,具有强效的络合能力,常用
2025-10-20 11:15

本研究利用臭氧去离子水(DIO3)开发了拥有成本低的新型清洗工艺(氧化亚钴),臭氧浓度为40ppm,用于去除有机蜡膜和颗粒,仅经过商业除蜡处理后,蜡渣仍超过200A。
2022-03-24 14:54
臭氧-去离子水 (O3 -DI) 工艺可以集成到臭氧 (O3) 具有工艺优势的各种水性应用中。 溶解在水中的臭氧也可用作 HCl 过氧化物混合物中过氧化氢的替代品,从而降低所用化学品的成本,同时将
2023-07-07 17:25
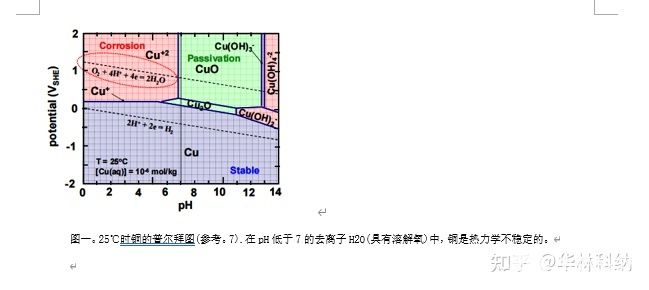
引言 我们华林科纳描述了一种与去离子水中铜的蚀刻相关的新的成品率损失机制。在预金属化湿法清洗过程中,含有高浓度溶解氧的水会蚀刻通孔底部的铜。蚀刻在金属化后残留的Cu中产生空隙,导致受影响的阵列电路中
2022-06-16 16:51
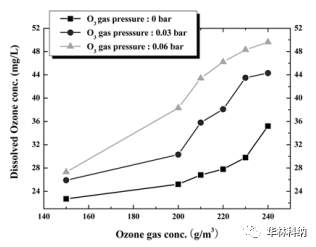
摘要 本研究开发了一种低拥有成本的臭氧去离子水清洗工艺。室温下40 ppm的臭氧浓度用于去除有机蜡膜和颗粒。仅经过商业脱蜡处理后,仍残留有厚度超过200的蜡残留物。由于臭氧的扩散限制反应,代替脱蜡器
2022-04-27 16:55
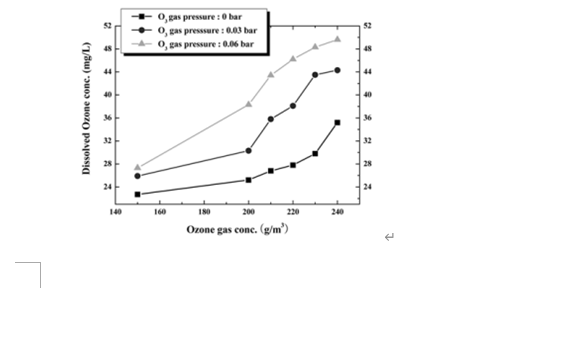
摘要 本研究开发了一种低拥有成本的臭氧去离子水清洗工艺。室温下40 ppm的臭氧浓度用于去除有机蜡膜和颗粒。仅经过商业脱蜡处理后,仍残留有厚度超过200的蜡残留物。由于臭氧的扩散限制反应,代替脱蜡器
2022-01-26 16:02
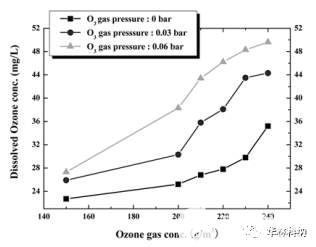
摘要 本研究开发了一种低拥有成本的臭氧去离子水清洗工艺。室温下40 ppm的臭氧浓度用于去除有机蜡膜和颗粒。仅经过商业脱蜡处理后,仍残留有厚度超过200的蜡残留物。由于臭氧的扩散限制反应,代替脱蜡器
2022-05-07 15:49
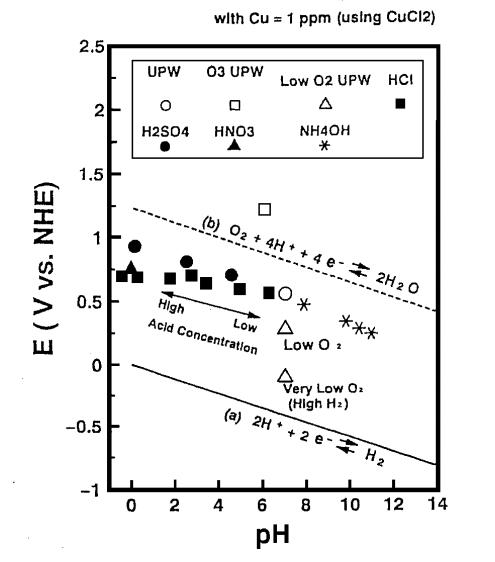
随着半导体科技的发展,在固态微电子器件制造中,人们对清洁基底表面越来越重视。湿法清洗一般使用无机酸、碱和氧化剂,以达到去除光阻剂、颗粒、轻有机物、金属污染物以及硅片表面上的天然氧化物的目的。然而,随着硅电路和器件结构规模的不断减小,英思特仍在专注于探索有效可靠的清洁方法以实现更好的清洁晶圆表面。
2023-06-05 17:18