结果表明,粘接层所受的应力主要集中在导电胶和芯片粘接界面边缘处,且粘接层四个角所受的应力最大,故在贴片工艺中要保证导电胶在芯片四个角的溢出,防止芯片脱落。适当增加导电胶的粘接层厚度,选取低弹性模量和低热膨胀系数的导电
2022-12-12 15:51
结果表明,粘接层所受的应力主要集中在导电胶和芯片粘接界面边缘处,且粘接层四个角所受的应力最大,故在贴片工艺中要保证导电胶在芯片四个角的溢出,防止芯片脱落。适当增加导电胶的粘接层厚度,选取低弹性模量和低热膨胀系数的导电
2022-12-09 11:24
在计算焊盘坐标时,数据手册中指定的芯片尺寸与从晶圆上切割后的物理芯片尺寸之间经常存在混淆。芯片的物理边缘不是引线键合的良好参考,因为整体芯片尺寸略有不一致。本应用笔记将
2023-06-16 17:23
在计算焊盘坐标时,经常有 数据中指定的模具尺寸之间的混淆 板材和从中切割后的物理模具尺寸 晶片。虽然不需要物理芯片尺寸 对于引线键合目的,重要的是 了解两者之间的区别 影响 整体物理
2023-02-20 11:06
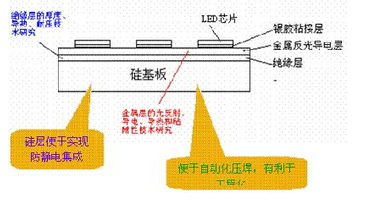
多芯片混合集成技术是实现瓦级LED的重要途径之一。由于传统小芯片工艺成熟,集成技术简单,侧光利用率较高(相对于大尺寸芯片),散热效果较好(相对于传统炮弹型LEDs),用
2019-09-19 16:34

FC-CSP 是芯片级尺寸封装(CSP)形式中的一种。根据J-STD-012 标准的定义口,CSP 是指封装体尺寸不超过裸芯片 1.2倍的一种封装形式,它通过凸块与基板
2023-05-04 16:19

虽然 WAT测试类型非常多,不过业界对于 WAT测试类型都有一个明确的要求,就是包括该工艺技术平台所有的有源器件和无源器件的典型尺寸。芯片代工厂会依据这些典型尺寸的特点,制定一套 WAT 参数,或者
2024-11-27 16:02

本文开始介绍了晶圆的概念和晶圆的制造过程,其次详细的阐述了晶圆的基本原料,最后介绍了晶圆尺寸的概念及分析了晶圆的尺寸是否越大越好。
2018-03-16 14:50
医疗设备设计的主要趋势之一 是使设备更接近患者 医生办公室或自己家里通过制作 这些设备更便携。这涉及所有 设计方面,尤其是影响尺寸和功率 消费。缩小这些电子部分 仪器的使用得到了极大的帮助 晶圆级 芯片级封装 (WLCSP)。
2023-01-31 16:39

在20世纪70年代、80年代和90年代的大部分时间里,最近的金属线半节距和栅极长度半节距的尺寸基本上相同,选择该值作为节点名称是因为它用单个数字传达了密度的概念和性能的概念。
2024-01-02 11:18