做过封装设计,做过PCB板级的设计,之前和网友有过交流,问题是:为什么要封装设计?信号完整性体系从大的方面来看:芯片级->封装级->板级。
2023-03-30 13:56
做过封装设计,做过PCB板级的设计,之前和网友有过交流,问题是:为什么要封装设计?信号完整性体系从大的方面来看:芯片级->封装级->板级。
2023-03-15 13:41

gaw9.2z39-4 U8位QFP散热焊盘过孔设计不良造成制程中锡膏流入孔中造成大量制程不良,钻孔大小16mil,背面无半塞处理!
2023-06-30 09:53
封装设计Design Rule 是在集成电路封装设计中,为了保证电气、机械、热管理等各方面性能而制定的一系列“约束条件”和“设计准则”。这些准则会指导工程师在基板走线、焊盘布置、堆叠层数、布线间距等方面进行合理规划,以确保封
2025-03-04 09:45
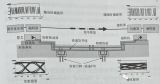
封装的主要功能之一是为芯片提供电源.以及为芯片提供通向外部和封装内其他芯片的电信号通路,其电气性能关系到I 能否在更高一级组装中正常工作。在设计中,应考量如下 3个方面。
2023-05-15 12:31

集成电路及其封装是典型的由名种材料构成的复合结构体系,也是典型的多物理场耦合系统。在封装技术发展的早期,多物理场赮合效应较弱,电设计与热机械可靠性设计通常是独立进行的,以降低设计难度。如今,集成电路
2023-05-17 14:24
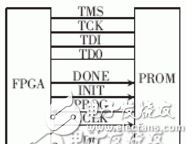
介绍了系统级封装的概念和特性,阐述了SiP设计的关键技术和基本生产实现流程。设计了一款基于ARM和FPGA管芯的SiP通用微处理系统,介绍了该SiP系统的整体框图,并详细分析了系统各部分电路的功能
2017-11-18 10:55

领先的晶圆代工厂组装和封测代工厂 (OSAT) 已经在为其客户提供高密度先进封装(HDAP) 服务了。晶圆代工厂/OSAT 目前提供的常见方法包括 2.5D-IC(基于中介层)和扇出型晶圆级封装(FOWLP) 方法(单裸片或多裸片),如图 1 所示。
2023-07-11 15:18
结果表明,粘接层所受的应力主要集中在导电胶和芯片粘接界面边缘处,且粘接层四个角所受的应力最大,故在贴片工艺中要保证导电胶在芯片四个角的溢出,防止芯片脱落。适当增加导电胶的粘接层厚度,选取低弹性模量和低热膨胀系数的导电胶,以及采较低的固化温度可大幅度降低器件的内应力,提高芯片剪切力。
2022-12-12 15:51