在 MEMS 制造工艺中,常用的干法刻蚀包括反应离子刻蚀 (Reactive lon Etching, RIE)、深反应离子刻蚀(Deep Reactive lon Etching, DRIE) 和XerF2各向同性
2022-10-10 10:12

主要介绍几种常用于工业制备的刻蚀技术,其中包括离子束刻蚀(IBE)、反应离子刻蚀(RIE)、以及后来基于高密度等离子体
2024-10-18 15:20
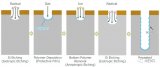
深反应离子刻蚀工艺,是实现高深宽比特性的重要方式,已成为微加工技术的基石。这项刻蚀技术在众多领域均得到了应用:1)MEMS电容式惯性传感器;2) 宏观设备的微型化;3) 三维集成电路堆叠技术的硅通孔工艺。
2020-10-09 14:17

。常见的干法刻蚀设备有反应离子刻蚀机(RIE)、电感耦合等离子体刻蚀机(ICP)、磁性中性线等离子体刻蚀机(NLD)、离子
2024-01-20 10:24
反应离子刻蚀技术是一种各向异性很强、选择性高的干法腐蚀技术。它是在真空系统中利用分子气体等离子来进行刻蚀的,利用了离子诱导化学反
2018-05-16 09:38
波音公司提出的嵌套环MEMS陀螺如图2(a)所示,其直径约8mm,环与环之间的间隙较大,可以用来设置内部电极用于驱动、检测或静电修调。该陀螺具有较大的等效质量和电容面积,采用深反应离子刻蚀技术进行加工。
2020-06-01 17:29
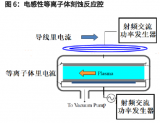
刻蚀可以分为湿法刻蚀和干法刻蚀。湿法刻蚀各向异性较差,侧壁容易产生横向刻蚀造成刻
2024-04-12 11:41

束经过离子枪聚焦、加速后作用于样品表面,实现离子的成像、注入、刻蚀和沉积。 截面分析是SEM/FIB(Scanning Electron Microscope/Focused Ion beam)双束系统
2023-10-07 14:44
反刻是在想要把某一层膜的总的厚度减小时采用的(如当平坦化硅片表面时需要减小形貌特征)。光刻胶是另一个剥离的例子。总的来说,有图形刻蚀和无图形刻蚀工艺条件能够采用干法刻蚀或湿法腐蚀技术来实现。为了复制硅片表面材料上的掩
2018-12-14 16:05