晶圆微凸点封装,更常见的表述是晶圆微凸点技术或晶圆级凸点技术(Wafer
2024-12-11 13:21
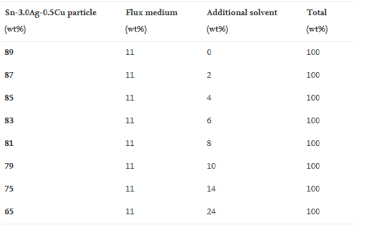
减小凸点间距和尺寸。无铅锡膏在封装中大量使用,目前在焊接凸点工艺中是不可或缺的材料。主流无铅锡膏包括了锡银铜和锡铋锡膏。无铅焊料的特性会受到配方的影响,例如助焊剂和合金
2024-01-22 10:04

随着异构集成模块功能和特征尺寸的不断增加,三维集成技术应运而生。凸点之间的互连 是实现芯片三维叠层的关键,制备出高可靠性的微凸点对微电子封装技术的进一步发展具有重要意
2023-07-06 09:56

先进封装技术持续朝着连接密集化、堆叠多样化和功能系统化的方向发展,探索了扇出型封装、2.5D/3D、系统级封 装等多种封装工艺。晶圆微凸点技术已被广泛应用于各种先进封装工艺技术中,是最重要的基础技术
2024-10-16 11:41

自从IBM于20世纪60年代开发出可控塌陷芯片连接(Controlled Collapse Chip Connect,C4)技术,或称倒装芯片技术,凸点键合在微电子封装领域特别是芯片与封装基板的键合
2023-12-05 09:40
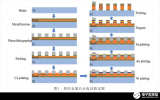
上的先进封装技术应运而生。微凸点作为实现芯片到圆片异构集成的关键结构,可有效缩短信号传输距离,提升芯片性能。利用电沉积法在 Si基板上以 Cu作支撑层、Ni作阻挡层淀积微米级别的 Au/Sn凸
2024-03-23 08:42

凸点(Bump)是倒装芯片的“神经末梢”,其从金凸点到Cu-Cu键合的演变,推动了芯片从平面互连向3D集成的跨越。未来,随着间距缩小至亚微米级、材料与工艺的深度创新,凸
2025-08-12 09:17 深圳市傲牛科技有限公司 企业号

延时短以及寄生参数小等优点,迅速成为当今中高端芯片封装领域的主流。在BGA芯片封装中,凸点制作工艺是至关重要的一环,它不仅关系到封装的可靠性和性能,还直接影响到封装
2024-11-28 13:11 北京中科同志科技股份有限公司 企业号

本文研究主要考虑基于CuSn金属互化物的微凸点(μbump)作为芯片堆叠的手段。系统研究了形成金属互化物凸点连接的两种方法。
2012-03-08 16:29

本文研究主要考虑基于CuSn金属互化物的微凸点(bump)作为芯片堆叠的手段。系统研究了形成金属互化物凸点连接的两种方法。一:瞬时液相(TLP)键合,在此过程中,全部S
2012-05-04 16:26