
的电、热、光和机械性能,决定着电子产品的大小、重量、应用方便性、寿命、性能和成本。针对集成电路领域先进封装技术的现状以及未来的发展趋势进行了概述,重点针对现有的先进
2024-06-23 17:00

level package),2.5D封装(interposer,RDL等),3D封装(TSV)等先进封装技术。
2023-08-05 09:54
近年来,先进封装技术的内驱力已从高端智能手机领域演变为高性能计算和人工智能等领域,涉及高性能处理器、存储器、人工智能训练和推理等。当前集成电路的发展受“四堵墙”(“存储墙”“面积墙”“功耗墙
2022-12-28 14:16

随着人工智能、高性能计算为代表的新需求的不断发展,先进封装技术应运而生,与传统的后道封装测试工艺不同,先进
2024-12-17 10:44

level package),2.5D封装(interposer,RDL等),3D封装(TSV)等先进封装技术。 审核
2024-02-21 10:34

半导体封装已从传统的 1D PCB 设计发展到晶圆级的尖端 3D 混合键合。这一进步允许互连间距在个位数微米范围内,带宽高达 1000 GB/s,同时保持高能效。先进半导体封装
2024-11-05 11:22

半导体产品在由二维向三维发展,从技术发展方向半导体产品出现了系统级封装(SiP)等新的封装方式,从技术实现方法出现了倒装(FlipChip),凸块(Bumping),晶
2023-10-31 09:16
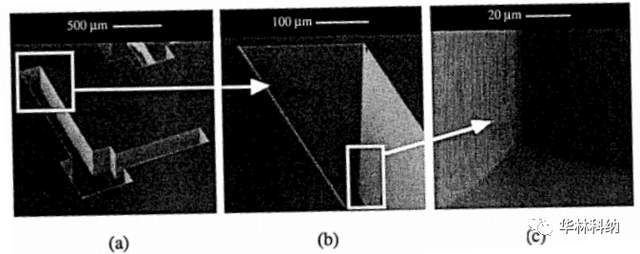
在本文中讲述了HARSE的工艺条件,其产生超过3微米/分钟的蚀刻速率和控制良好的、高度各向异性的蚀刻轮廓,还将成为展示先进封装技术的潜在应用示例。
2022-05-09 15:11

随着半导体技术的不断发展,先进封装作为后摩尔时代全球集成电路的重要发展趋势,正日益受到广泛关注。受益于AI、服务器、数据中心、汽车电子等下游强劲需求,半导体封装朝着多功
2024-10-28 09:10

技术发展方向 半导体产品在由二维向三维发展,从技术发展方向半导体产品出现了系统级封装(SiP)等新的封装方式,从技术实现
2020-10-12 11:34