
(Through Silicon Via,简称TSV)正在成为新的主流。加装芯片键合也被称作凸点键合(Bump Bonding),是利用锡球(Solder Ball)小凸点进行键合的
2023-08-09 09:49
电子装联技术的发展随元器件封装形式的发展而发展,俗话说,一代元器件,一代组装工艺。由于SMT中采用“无引线或短引线”的元器件,故从组装工艺角度分析,SMT与THT的主要区別:
2019-11-18 09:29
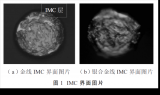
介绍了封装键合过程中应用的银合金键合线与铝垫之间形成的共金化合物(IMC),提出了侵蚀对IMC的影响,由于银合金线IMC不能通过物理方法确认,需通过软件测量计算和化学腐蚀试验得到IMC覆盖面积。详述
2023-10-20 12:30
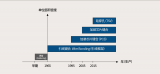
Bonding)和硅穿孔(Through Silicon Via,简称TSV)正在成为新的主流。 加装芯片键合也被称作凸点键合(Bump Bonding),是利用锡球(Solder Ball)小凸点进行键合的
2023-03-13 15:49
合路器的损耗是一个关键的性能指标,它反映了合路器在将多路信号合成一路过程中对信号功率的衰减程度。关于合路器损耗的正常范围
2024-08-13 14:57

较大的材料进行键合时,传统的高温键合方法已经不再适用。如何在较低退火温度甚至无需加热的室温条件下,实现牢固的键合是晶圆键合领域的一项挑战。本文以晶圆直接键合为主题,简单
2023-06-14 09:46

我们在使用示波器的时候,要想稳定的显示波形,我们往往需要选择一个合适的触发方式。而在功率测量领域,如何实现“电压”和“电流”的同步测量至关总要,今天我们就来揭秘周立功致远电子是如何来实现功率测量的“神同步”!
2015-07-22 16:30
本文首先介绍了什么是合路器以及合路器的作用,然后介绍了合路器的主要分类,并且解释了什么是耦合器,最后对合路器和耦合器的异同进行了粗略说明。
2019-08-06 10:00